APAC 다이 부착 장비 시장 규모

| 학습 기간 | 2019 - 2029 |
| 산정기준연도 | 2023 |
| 예측 데이터 기간 | 2024 - 2029 |
| 과거 데이터 기간 | 2019 - 2022 |
| CAGR | 15.30 % |
| 시장 집중 | 중급 |
주요 선수
*면책조항: 주요 플레이어는 특별한 순서 없이 정렬되었습니다. |
코로나19가 이 시장과 성장에 어떤 영향을 미쳤는지 반영하는 보고서가 필요하십니까?
APAC 다이 부착 장비 시장 분석
다이 어태치 장비 시장은 예측 기간 동안 연평균 15.3% 성장할 것으로 예상됩니다. 시장은 아래 언급된 경향에 의해 생성된 조립 및 패키징 기회의 혜택을 받을 것으로 예상됩니다.
- 시장 공급업체의 다음 투자 라운드에서 중요한 초점은 더 작고 고도로 복잡한 5G 호환 스마트폰을 위한 다이 본딩 및 패키징 솔루션을 개발하는 것입니다. 5G는 미래 혁신을 위한 통합 연결 플랫폼으로 훨씬 더 빠른 데이터 및 비디오 전송 속도로 지속적으로 안전한 클라우드 액세스를 가능하게 합니다.
- 5G 기능의 사용자 채택은 모바일 광대역 활동을 확장하고 만물 인터넷을 위한 인공 지능 사용을 가속화합니다. 마찬가지로 모바일 인터넷, 컴퓨팅, 5G 및 자동차 최종 사용자 애플리케이션을 위한 기판 및 웨이퍼 레벨 패키징 프로세스는 반도체 산업이 메모리 및 로직에 대한 자본 투자를 회복하도록 이끌었습니다.
- 이 회사는 확장된 반도체 및 FPD 애플리케이션을 위한 자본 투자의 중장기적 증가 계획을 공유했습니다. 반면 Shibaura에 따르면 반도체 조립 장비에서 FOWLP/PLP 및 μLED용 고속 고정밀 본딩 장비의 개발이 활발히 진행되고 있습니다.
- BESI는 새로운 디지털 사회를 위한 FOWLP, TCB, TSV, 초박형 다이, 하이브리드 본딩, 대면적, 웨이퍼 레벨 몰딩, 태양열 및 3D-리튬 이온 배터리 도금과 같은 새로운 조립 기술에 대한 투자 계획을 공유했습니다. Die Attach 장비의 라인업에는 Single Chip, Multi-Chip, Multi-Module, Flip Chip, TCB, FOWLP, Hybrid Die Bonding System, Die Sorting System 등이 있습니다.
- 다만, 코로나19의 전 세계적 확산 영향으로 불확실성이 지속되고 있는 점은 우려의 대상이다. COVID-19 발생으로 인한 아시아 태평양 전역의 폐쇄 및 생산 중단은 반도체 생산 및 소비에 큰 영향을 미쳤습니다. 대부분의 IDS 및 파운드리 공장이 이 지역에 있기 때문에 폐쇄의 영향으로 자본 투자에 대한 지출이 감소했습니다. 이는 연구 대상 시장에 영향을 미칠 가능성이 높으며 2021년에는 회복이 둔화될 것으로 예상됩니다.
APAC 다이 부착 장비 시장 동향
이 섹션에서는 연구 전문가에 따라 APAC 다이 부착 장비 시장을 형성하는 주요 시장 동향을 다룹니다.
CIS는 상당한 성장을 목격할 것으로 예상됩니다.
- CMOS 이미지 센서는 스마트폰 및 기타 제품에 카메라 기능을 제공해 왔으며 스케일링 수요가 증가함에 따라 팹의 관련 제조 문제가 발생합니다.
- 고대역폭 데이터 성능은 3G에서 4G로 발전했고, 현재 5G로 넘어가면서 더 높은 품질의 카메라에 대한 요구가 커졌습니다. 이러한 추세는 더 높은 픽셀 수와 더 나은 해상도에 대한 필요성을 기반으로 CMOS 이미지 센서 스태킹 기술을 추진했습니다. 이러한 추세 외에도 생체 인식 ID, 3D 감지 및 향상된 인간 시각 응용 분야 영역에서 세그먼트 성장이 증가했습니다.
- 더 크고 더 나은 카메라에 대한 고객의 요구는 더 큰 다이 크기를 가진 더 많은 센서로 이어집니다. 픽셀 스케일링 외에도 CMOS 이미지 센서는 다이 스태킹과 같은 다른 혁신을 겪고 있습니다. 조사 대상 시장의 공급업체는 TSV(through-silicon vias), 하이브리드 본딩, 픽셀 대 픽셀과 같은 서로 다른 상호 연결 기술도 사용하고 있습니다.
- 예를 들어 하이브리드 본딩에서 다이는 구리 간 상호 연결을 사용하여 연결됩니다. 이를 위해 두 개의 웨이퍼가 팹에서 처리됩니다. 하나는 로직 웨이퍼이고 다른 하나는 픽셀 어레이 웨이퍼입니다. 두 개의 웨이퍼는 유전체-유전체 결합을 사용하여 결합된 다음 금속-금속 연결이 이어집니다.
- Xperi의 독자적인 기술인 하이브리드 본딩 DBI 기술은 삼성이 휴대폰용 CMOS 이미지 센서 제조에 적극적으로 활용하고 있습니다. CMOS 이미지 센서를 위한 이 기술은 실온 Cu-Cu 영구 접합, 저온 어닐링(약 300°C) 및 외부 압력 접합 공정(유전체/금속)이 필요하지 않습니다.
- 이에 앞서 다이렉트 본드 기술은 픽셀 스케일링(후면 조명) BSI 및 Xperifor가 15년 이상 주도하는 여러 세대의 변형이 있는 적층 BSI의 실현에 중요한 역할을 했습니다.

시장점유율을 지배하는 LED
- 다이 부착 재료는 중, 고, 초고 전력 LED의 성능과 신뢰성에서 중요한 역할을 합니다. LED 보급률이 높아짐에 따라 die-attach 장비에 대한 수요가 증가하고 있습니다. 특정 칩 구조 및 애플리케이션에 적합한 다이 부착 재료의 선택은 패키징 프로세스(처리량 및 수율), 성능(열 발산 출력 및 광 출력), 신뢰성(광속 유지) 및 비용을 포함하는 다양한 고려 사항에 따라 달라집니다. 공융 금-주석, 은 충전 에폭시, 땜납, 실리콘 및 소결 재료는 모두 LED 다이 부착에 사용되었습니다.
- SFE는 0.2 * 90 규격의 칩 크기로 250초/주기(250% 작동률)의 인덱스 시간을 특징으로 하는 LED Epoxy Die Bonder 기계를 사용하여 2개의 카메라를 통해 리드 프레임 인식을 제공하는 에폭시 접착제 접합 방법을 제공합니다. 소프트웨어 기능은 자동 마운트 레벨 및 픽업 레벨 교육 기능을 제공합니다.
- 또한 전도성 접착제(주로 은으로 채워진 에폭시)는 LED용 열 다이 부착 재료(단위 번호 기준)의 가장 큰 부류를 구성합니다. 기존 백엔드 패키징 장비와 호환되며 매력적인 비용/성능 균형을 제공합니다(보통 50차 리플로우 호환성을 갖춘 최대 XNUMXW/mK 열). 베어 실리콘에 달라붙기 때문에 GaN on Silicon과 같은 백엔드 금속화가 없는 다이에 가장 선호되는 재료입니다.
- 또한 LED 시장에는 많은 경쟁업체가 존재하며 ASM은 이 시장에서 두각을 나타내는 업체 중 하나입니다. LED 에폭시 고속 다이본더 AD830은 LED 시장을 지배하고 있습니다. +/-1mil 및 +/-3도의 다이 배치 정확도로 빠르고 안정적이며 정확하며 10mil x 10mil과 같은 소형 칩의 사이클 시간은 180ms이며 이는 UPH 18,000에 해당합니다. 사전 설정된 배치 범위에서 접착 장치를 모니터링하는 사후 접착 검사 시스템이 장착되어 있습니다.

APAC 다이 부착 장비 산업 개요
APAC 다이 어태치 장비 시장은 시장 점유율이 적은 다수의 플레이어와 함께 적당히 경쟁적입니다. 회사는 시장 점유율을 유지하기 위해 지속적으로 혁신하고 전략적 파트너십을 체결합니다.
- 2022년 100월 - DER-IC(전기 혁명 산업화 센터) 추진 North East는 도구 및 재료의 최고 기술 유통업체인 Inseto로부터 PEMD(전력 전자, 기계 및 드라이브) 기능을 개선하기 위한 장비를 받았습니다. 영국에 설치될 최초의 마이크로 펀치 기계는 AMX PXNUMX 소결 프레스로, 제공되는 장비의 일부이며 고신뢰성, 고출력 모듈 생산을 가능하게 할 것입니다.
- 2022년 7월 - 새로운 XNUMXKF Bonder 시리즈가 West Bond에서 개발되었습니다. 이 잘 알려진 회사는 마이크로전자 패키징 산업을 위한 와이어 본딩 및 다이-어태치 기계, 와이어 인장 및 전단 테스트 장비, 초음파 부품 및 액세서리 라인을 설계 및 제조합니다. 이 뛰어난 도구는 RF, 마이크로웨이브, 반도체, 하이브리드 및 의료 기기 분야에서 발견되는 까다로운 본딩 애플리케이션을 처리하도록 만들어졌습니다.
APAC 다이 부착 장비 시장 리더
팔로마 테크놀로지스
주식회사 신카와
파나소닉
ASM 태평양 기술 제한
Be Semiconductor Industries NV
*면책조항: 주요 플레이어는 특별한 순서 없이 정렬되었습니다.
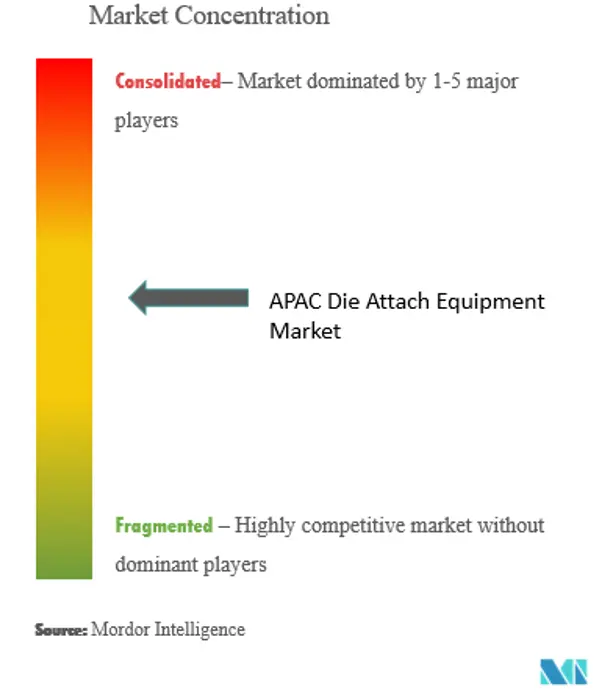
APAC 다이 부착 장비 시장 뉴스
- 2022년 2월 - MEMS, 나노기술 및 반도체 시장을 위한 웨이퍼 본딩 및 리소그래피 장비 공급업체인 EV Group(EVG)에 따르면 D100W(die-to-wafer) 퓨전 및 하이브리드 본딩의 주요 발전이 이루어졌습니다. 이는 EVG의 GEMINI를 사용하여 단일 전송 프로세스에서 전체 3D SoC(시스템 온 칩)에서 다양한 크기의 여러 다이에 대한 2% 공극 없는 본딩 수율을 성공적으로 시연함으로써 달성되었습니다. 지금까지 이러한 위업을 달성하는 것은 DXNUMXW 본딩에 큰 어려움이었으며 이기종 통합 구현 비용을 낮추는 데 큰 장애물이었습니다.
- 2022년 3월 - 선도적인 고급 ASIC인 GUC(Global Unichip Corp.)는 SK Hynix가 공개한 첫 번째 HBM7.2 샘플을 사용하여 자사의 3Gbps HBM2022 솔루션이 실리콘으로 입증되었음을 밝혔습니다. 이 플랫폼은 TSMC 3 북미 기술 심포지엄의 파트너 파빌리온에 전시되었습니다. HBM2.5 컨트롤러, PHY, GLink-112D 다이-다이 인터페이스 및 XNUMXG SerDes가 특징입니다. TSMC CoWoS-S(실리콘 인터포저) 및 CoWoS-R(유기 인터포저) 고급 플랫폼 모두 패키징 기술을 지원합니다.
APAC 다이 부착 장비 시장 보고서 - 목차
1. 소개
1.1 연구 가정 및 시장 정의
1.2 연구 범위
2. 연구 방법론
3. 행정상 개요
4. 시장 역 동성
4.1 시장 개관
4.2 산업 매력 - Porter의 다섯 가지 힘 분석
4.2.1 공급 업체의 협상력
구매자의 4.2.2 협상력
신규 참가자의 4.2.3 위협
대체의 4.2.4 위협
4.2.5 경쟁적 경쟁의 강도
4.3 산업 가치 사슬 분석
4.4 Covid-19가 시장에 미치는 영향
5. 시장 운전사
5.1 AuSn 공융 다이 접착 기술의 수요 증가
5.2 개별 전력 소자의 수요
6. 시장 도전
6.1 가공 중 치수 변화 및 수명과 기계적 불균형
7. 시장 세분화
7.1 본딩 기법별
7.1.1 다이 본더
7.1.1.1 에폭시/접착제(페이스트/필름)
7.1.1.2 공융
7.1.1.3 솔더
7.1.1.4 소결
7.1.2 플립 칩 본더
7.1.2.1 픽앤플레이스/리플로우 솔더링
7.1.2.2 열압착(TCB)
7.1.2.3 열음파 접합
7.1.2.4 하이브리드 본딩
7.2 응용 프로그램
7.2.1 메모리
7.2.2 LED
7.2.3 논리
7.2.4 CMOS 이미지 센서
7.2.5 광전자공학/포토닉스
7.2.6 개별 전원 장치
7.2.7 MEMS 및 센서
7.2.8 스택 메모리 및 RF
7.3 국가
7.3.1 대만
7.3.2 중국
7.3.3 일본
7.3.4 한국
7.3.5 동남아시아
8. 경쟁 구도
8.1 회사 프로필*
8.1.1 팔로마 테크놀로지스
8.1.2 신카와 주식회사
8.1.3 파나소닉 코퍼레이션
8.1.4 ASM 태평양 기술 제한
8.1.5 Be Semiconductor Industries NV(Besi)
8.1.6 시바우라 메카트로닉스 주식회사
8.1.7 ficonTEC Trading Ltd(ficonTEC Service GmbH)
8.1.8 파스포드 테크놀로지 주식회사
8.1.9 동관 Hoson 전자 기술 회사
8.1.10 (주)테크노스의 경우
8.1.11 Shenzhen Xinyichang Technology Co., Ltd.(호손)
9. 벤더 시장 점유율 분석 - 2021년
10. 투자 분석
11. 시장의 미래
APAC 다이 부착 장비 산업 세분화
다이 부착은 반도체 패키징에서 중요한 공정입니다. 다양한 응용 분야의 모든 장치를 포괄하며 조립 비용에 기여합니다. 다이 본딩은 반도체 패키징에 사용되는 제조 공정입니다. 다이 배치 또는 다이 부착이라고도 하는 에폭시 또는 솔더로 기판 또는 패키지에 다이(또는 칩)를 부착하는 행위입니다.
시장은 Technique(Die bonder(Epoxy/Adhesive, Eutectic, Solder, Sintering), Flip chip bonder(Pick and Place/reflow soldering, Thermocompression, Thermosonic Bonding, Hybrid Bonding)), Application(Memory, LED, Logic, CMOS Image Sensor(CIS), Optoelectronics/Photonics, Discrete Power Devices, MEMS & Sensors, Stacked Memory & RF) 및 국가(대만, 중국, 일본, 한국, 동남아시아).
| 본딩 기법으로 | ||||||
| ||||||
|
| 어플리케이션 | |
| 메모리 | |
| LED | |
| 논리 | |
| CMOS 이미지 센서 | |
| 광전자공학/포토닉스 | |
| 개별 전원 장치 | |
| MEMS 및 센서 | |
| 스택 메모리 및 RF |
| 국가 | |
| 대만 | |
| 중국 | |
| 일본 | |
| 대한민국 | |
| 동남 아시아 |
APAC 다이 부착 장비 시장 조사 FAQ
현재 APAC 다이 부착 장비 시장 규모는 얼마입니까?
APAC 다이 어태치 장비 시장은 예측 기간(15.30-2024) 동안 2029%의 CAGR을 기록할 것으로 예상됩니다.
이 APAC 다이 부착 장비 시장의 핵심 플레이어는 누구입니까?
Palomar Technologies, Inc., Shinkawa Ltd., Panasonic Corporation, ASM Pacific Technology Limited 및 Be Semiconductor Industries NV는 APAC 다이 부착 장비 시장에서 활동하는 주요 회사입니다.
이 APAC 다이 부착 장비 시장은 몇 년 동안 다루나요?
이 보고서는 2019, 2020, 2021, 2022 및 2023년 동안 APAC 다이 부착 장비 시장의 역사적 시장 규모를 다룹니다. 또한 이 보고서는 2024년, 2025년, 2026년, 2027, 2028 및 2029년 동안 APAC 다이 부착 장비 시장 규모를 예측합니다. .
APAC 다이 부착 장비 산업 보고서
Mordor Intelligence™ Industry Reports에서 생성한 2024년 APAC 다이 부착 장비 시장 점유율, 규모 및 매출 성장률에 대한 통계. APAC 다이 부착 장비 분석에는 2029년까지의 시장 예측 전망과 과거 개요가 포함됩니다. 이 산업 분석 샘플을 무료 보고서 PDF 다운로드로 받으십시오.
